陶瓷基板 (Ceramic PCB, Ceramic Substrate)
作者:江志宏
📘 摘要總覽(TL;DR)
摘要:
陶瓷基板具高導熱與絕緣特性,廣泛應用於高功率LED、車燈與太陽能裝置。
TL(Too Long):
陶瓷基板常用材料為氧化鋁與氮化鋁,具耐高溫、抗濕熱及優良尺寸穩定性,適合惡劣環境。
DR(Did Read):
陶瓷基板因熱膨脹係數接近半導體晶片,能有效減少封裝應力,並具高導熱(Al2O3:20–40W/mK,AlN:170–220W/mK):contentReference[oaicite:1]{index=1}。氧化鋁價格低、製程簡單,適合一般應用;氮化鋁導熱佳但成本高,多用於高階散熱需求。製程包含薄膜(高精度線路)、厚膜(耐候散熱)、LTCC(嵌入被動元件)。可靠度測試依 IEC 60068 系列,涵蓋 −40↔85℃ 溫度循環、冷熱衝擊(155℃/−55℃ 300 cycles)、85℃ 高溫、3M膠帶附著力與紅墨水滲透實驗,確保基板能承受高濕、溫差與長期操作環境。
說明
陶瓷基板為電路板的一種,與傳統FR-4或鋁基板不同的是,其具有與半導體接近的熱膨脹係數及高耐熱能力,適用於具備高發熱量的產品(高亮度LED、太陽能),其優異的耐候特性更可適用於較惡劣之戶外環境。
📌 實務案例
LED 車燈廠選用 AlN 陶瓷基板,進行 IEC 60068-2-14 冷熱衝擊(−55↔155℃,300 cycles),部分樣品出現金屬化剝離,後續改善附著層後通過測試。
某太陽能 inverter 模組依 IEC 60068-2-78 濕熱(85℃/85%RH/1000h)驗證,氧化鋁基板 CAF 擴展失效,改用氮化鋁後熱導率與可靠度顯著提升。
一高功率 LED 路燈載板於紅墨水測試中發現滲透,工程團隊優化 LTCC 製程密實度後改善問題。
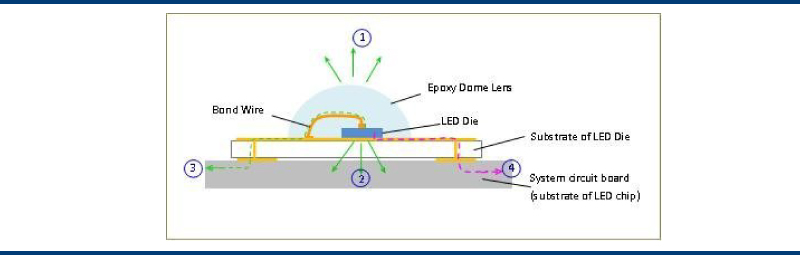
主要應用產品:高功率LED載板、LED車燈、LED路燈、太陽能inverter
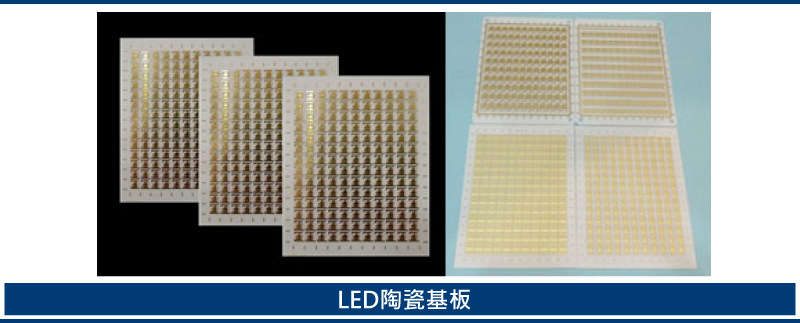
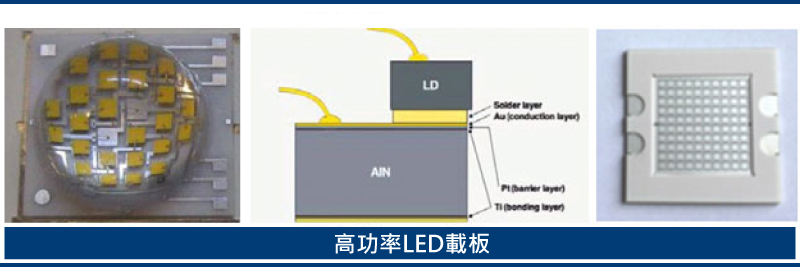

陶瓷基板特色:
結構:優秀機械強度、低曲翹度、熱膨脹係數接近矽晶圓(氮化鋁)、高硬度、加工性好、尺寸精度高
氣候:適用高溫高濕環境、熱導率高、耐熱性佳、耐腐蝕與磨耗、抗UV&黃化
化學:無鉛、無毒、化學穩定性好
電性:高絕緣電阻、容易金屬化、電路圖形與之附著力強
市場:材料豐富(陶土、鋁) 、製造容易、價格低

PCB材料熱特性比較(傳導率):
玻璃纖維基板(傳統PCB):0.5W/mK、鋁基板:1~2.2W/mK、陶瓷基板:24[氧化鋁]~170[氮化鋁]W/mK
材料熱傳導係數(單位W/mK):
樹酯:0.5、氧化鋁:20-40、碳化矽:160、鋁:170、氮化鋁:220、銅:380、鑽石:600
陶瓷基板製程分類:
依線路陶瓷基板製程分為:薄膜、厚膜、低溫共燒多層陶瓷(LTCC)
薄膜製程(DPC):精確控制元件線路設計(線寬與膜厚)
厚膜製程(Thick film):提供散熱途徑與耐候條件
低溫共燒多層陶瓷(HTCC):利用玻璃陶瓷具低燒結溫度,可和低熔點、高導電性貴重金屬共燒的特性,實現多層陶瓷基板)和構裝。
低溫共燒多層陶瓷(LTCC):堆疊數個陶瓷基板並嵌入被動元件以及其他IC
薄膜陶瓷基板製程:
‧前處理→濺鍍→光阻披覆→曝光顯影→線路電鍍→去膜
‧疊片→熱壓→脫脂→基片燒成→形成電路圖形→電路燒成
‧疊片→表面印刷電路圖形→熱壓→脫脂→共燒
‧印刷電路圖形→疊層→熱壓→脫脂→共燒
陶瓷基板厚膜與薄膜線路差異:

薄膜與厚膜製程產品之差異分析:
| 薄膜製程 |
厚膜製程 |
|
| 線路精準度 |
精準度較高問差低於±1% |
以印刷方式成形誤差值較高±10% |
| 鍍層材料 |
材料穩定度較高 |
易受漿料均勻性影響 |
| 鍍層表面 |
表面平整度高 |
平整度低誤差值約1~3um |
| 設備維護 |
維護較不易,費用較高 |
生產設備維護較為簡易 |
| 鍍層附著性 |
無須高溫燒結,不會有氧化物生成,附著性佳 |
附著性受基板材料影響AIN基板尤差 |
| 線路位置 |
使用曝光顯影,相對位置精準度高 |
受網版張力及印刷次數影響,相對位置精準度低 |
表面電鍍材料分為:氧化鋁(Al203)、氮化鋁(AIN)、氧化镀(BeO)
氮化鋁與氧化鋁特性比較:
氧化鋁:材料取得容易、成本較低、製程較簡單、熱傳導係數較差
氮化鋁:材料取得不易、成本較高、製程較難、熱傳導係數較佳

氮化鋁與氧化鋁導熱性比較:

陶瓷基板可靠度試驗條件:
陶瓷基板高溫操作:85℃
陶瓷基板低溫操作:-40℃
陶瓷基板冷熱衝擊:1. 155℃(15min)←→-55℃(15min)/300cycle 2. 85℃(30min)←→-40℃(30min)/RAMP:10min(12.5℃/min)/5cycle
陶瓷基板附著力:以3M#600之膠帶密貼於板面,30秒後與板面成90°方向速撕,不得脫落。
陶瓷基板紅墨水實驗:煮沸一小時,不可滲透
氮化鋁與氧化鋁導熱性比較:
三氧化二鋁(Al2O3)
氮化鋁(AlN)
陶瓷基板(Ceramic PCB , Ceramic Substrate , Ceramic circuit board)
晶片(chip)
薄膜陶瓷:COB (Chip On Board)
晶粒(Die)
薄膜製程(DPC)
蒸鍍(Evaporation)
LED載板(LED Lighting Board)
低溫共燒層陶瓷(LTCC)
絕緣層(Polymer)
厚膜製程(Thick film)
打線(Wire bonding)
濺鍍(Sputtering)
散熱基板(Submount)
常見問與答(FAQ)
主要有氧化鋁(Al2O3)與氮化鋁(AlN),前者成本低、製程簡單,後者導熱性佳、耐高溫,適合高功率應用。
薄膜精度高、表面平整,適合精細線路;厚膜則具散熱與耐候性,成本較低,常用於大電流與戶外應用。
包含高溫操作、低溫操作、溫度循環、冷熱衝擊、附著力與紅墨水實驗,以模擬高濕與極端溫差情境。
因為氮化鋁導熱係數高達 170–220W/mK,能有效散熱並減少熱應力,對高亮度 LED 與功率模組特別有利。
廣泛應用於高功率 LED、車燈、路燈、太陽能 inverter、電源模組與高速電子元件,特別適合高散熱需求。


